SoC (系統單晶片) 集成度更高, 功耗更低, 性能更好; 而 SiP 的靈活性更高, 更廣泛的兼容性, 成本更低, 生產周期更短. 生命周期相對較長的產品適用 SoC, 生命周期短, 面積小的產品, SiP 更有優勢.
因為系統級封裝 (SiP) 內部走線的密度可以遠高於 PCB 走線密度, 從而解決 PCB 線寬帶來的系統瓶頸. 例如記憶體晶片和處理器晶片可以通過穿孔的方式連接在一起, 帶寬可不再受 PCB 線寬的限制.
將行動終端拆解可分為四個層次, 晶片處於最底層通過封裝和組裝技術而成為有效的零部件, 隨著消費電子輕薄化和功能化需求的提升, 在 Level 1+2 封裝和組裝環節都越來越多採取 SiP 的方案.
在手機中做成 SiP 方案的零組件部分就包括了電源管理類, 射頻前端模組, MEMS, 無線連接模塊, 傳感器, 記憶體等, 幾乎涵蓋了手機中大部分零部件. 隨著 5G 應用展開, 射頻前端的價值提升最明顯.
4G 時代射頻前端 SiP 的主要供應商是 IDM (整合設備廠), 同時也會外包部分 SiP 業務給 OSAT (封測代工廠). 5G 之後, 我們預估產業鏈的格局正在發生變化. 高通的切入將會使得市場競爭格局重新分布.
IDM 模式廠商全流程負責晶片設計, 制造和封測的生產流程, OSAT 模式則是為晶片設計企業提供封裝測試代工服務. 從技術演進層面看封測行業可分為傳統封裝和先進封裝, 先進封裝的成長空間大.
傳統封裝領域 OSAT 憑借行業資本密集, 技術密集, 勞動密集的高門檻, 通過規模效應降低成本, 獲得比 IDM 廠商更低的成本優勢並擴大市佔. 在先進封裝領域則是要面臨產業上下游的競爭.
先進封裝目前有兩大發展方向, 晶圓級封裝 (WaferLevel Package): 即在更小的封裝面積下,容納更多的引腳數. 系統級封裝 (SiP): 即整合多種功能晶片於一體. 在壓縮體積的同時, 也提高了傳輸效率.
SiP 封裝概念股有 "日月光" (EMS:環旭/封裝/測試), "南電" (IC 載板與 PCB), "景碩" (以手機基頻為主的封裝基板), "訊芯" (光收發模組/SiP/車用電子模組), "頎邦" (Gold Bump/COF/COG) 等.
因為系統級封裝 (SiP) 內部走線的密度可以遠高於 PCB 走線密度, 從而解決 PCB 線寬帶來的系統瓶頸. 例如記憶體晶片和處理器晶片可以通過穿孔的方式連接在一起, 帶寬可不再受 PCB 線寬的限制.
將行動終端拆解可分為四個層次, 晶片處於最底層通過封裝和組裝技術而成為有效的零部件, 隨著消費電子輕薄化和功能化需求的提升, 在 Level 1+2 封裝和組裝環節都越來越多採取 SiP 的方案.
在手機中做成 SiP 方案的零組件部分就包括了電源管理類, 射頻前端模組, MEMS, 無線連接模塊, 傳感器, 記憶體等, 幾乎涵蓋了手機中大部分零部件. 隨著 5G 應用展開, 射頻前端的價值提升最明顯.
4G 時代射頻前端 SiP 的主要供應商是 IDM (整合設備廠), 同時也會外包部分 SiP 業務給 OSAT (封測代工廠). 5G 之後, 我們預估產業鏈的格局正在發生變化. 高通的切入將會使得市場競爭格局重新分布.
IDM 模式廠商全流程負責晶片設計, 制造和封測的生產流程, OSAT 模式則是為晶片設計企業提供封裝測試代工服務. 從技術演進層面看封測行業可分為傳統封裝和先進封裝, 先進封裝的成長空間大.
傳統封裝領域 OSAT 憑借行業資本密集, 技術密集, 勞動密集的高門檻, 通過規模效應降低成本, 獲得比 IDM 廠商更低的成本優勢並擴大市佔. 在先進封裝領域則是要面臨產業上下游的競爭.
先進封裝目前有兩大發展方向, 晶圓級封裝 (WaferLevel Package): 即在更小的封裝面積下,容納更多的引腳數. 系統級封裝 (SiP): 即整合多種功能晶片於一體. 在壓縮體積的同時, 也提高了傳輸效率.
SiP 封裝概念股有 "日月光" (EMS:環旭/封裝/測試), "南電" (IC 載板與 PCB), "景碩" (以手機基頻為主的封裝基板), "訊芯" (光收發模組/SiP/車用電子模組), "頎邦" (Gold Bump/COF/COG) 等.


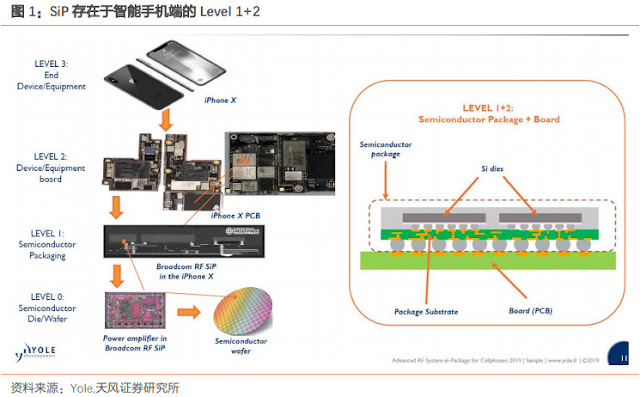

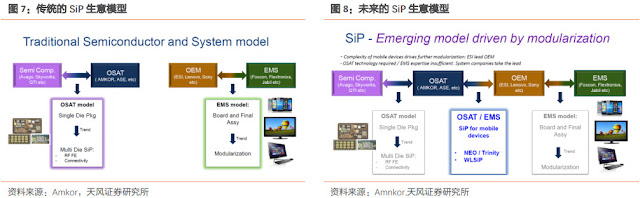




日月光控股看淡本季 全年營運表現有信心成長
回覆刪除https://tw.appledaily.com/new/realtime/20190130/1510413/
南電受惠5G和SiP載板增溫 今年獲利目標轉正
回覆刪除https://money.udn.com/money/story/5612/3596213
力成去年每股賺8.02元 創8年來高點
回覆刪除https://money.udn.com/money/story/5612/3623193
訊芯上季獲利衝2年高點,去年每股賺2.83元
回覆刪除https://m.ctee.com.tw/livenews/aj/20190322003700-260410